裏面加工
ウェーハの薄型化研削研磨・裏面電極付けまでを一貫で対応します。
| 加工実績 | GaAs | 30μm~ 対応可能です。 |
| InP | 80μm~ 対応可能です。 | |
| Si | 30μm~ 対応可能です。 |
- 各種ウェーハの裏面研削加工
- 各種ウェーハの裏面金属付け加工
高周波用途のデバイスは、近年さらに高周波化、高パワー化が要求されています。その際、問題となるのが、ウェーハ裏面加工であり、ウェーハをより薄く加工する事が必要です。その様な薄いウェーハは、ハンドリング等、非常に難しくなります。薄くしたがハンドリングが出来ない等のプロセスについて、当社では裏面加工からダイシングまでを一貫で行うことにより、そのような問題を一気に解決しています。
(1)バックグラインド加工仕様
バックグラインドプロセスについては、現在2仕様の加工が量産化されています。 2仕様の加工プロセスについては下表の通り、100から150μm以下の薄型加工プロセスAとそれ以上の厚み加工を行うプロセスBに分かれています。
■加工プロセス・A:150μm以下の厚み加工プロセス
サファイヤ等の支持基板を使用するプロセス
サファイヤ等の支持基板を使用するプロセス
■加工プロセス・B:150μm以上の厚み加工プロセス
BGテープを使用するプロセス
BGテープを使用するプロセス
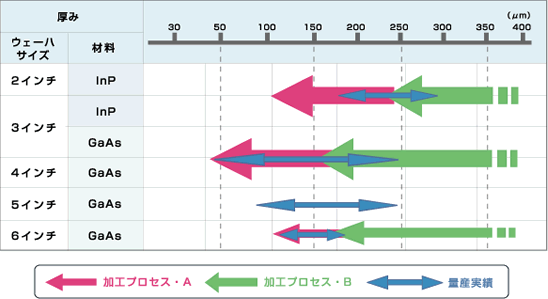
(2)バックグラインド歪の取り除き方法
ポリッシング、エッチングを組み合わせて歪取りを行います。

(3)裏面金属膜付け加工
裏面金属付けは、スパッター装置を使用します。

(4)金メッキ加工
*ウェーハ面内の厚みバラツキ




